【導(dǎo)讀】以下為大家詳細(xì)介紹九種常見的元器件封裝技術(shù)。元件封裝起著安裝、固定、密封、保護(hù)芯片及增強(qiáng)電熱性能等方面的作用。同時(shí),通過芯片上的接點(diǎn)用導(dǎo)線連接到封裝外殼的引腳上,這些引腳又通過印刷電路板上的導(dǎo)線與其他器件相連接,從而實(shí)現(xiàn)內(nèi)部芯片與外部電路的連接。
因此,芯片必須與外界隔離,以防止空氣中的雜質(zhì)對(duì)芯片電路的腐蝕而造成電氣性能下降。而且封裝后的芯片也更便于安裝和運(yùn)輸。由于封裝的好壞,直接影響到芯片自身性能的發(fā)揮和與之連接的PCB設(shè)計(jì)和制造,所以封裝技術(shù)至關(guān)重要。
衡量一個(gè)芯片封裝技術(shù)先進(jìn)與否的重要指標(biāo)是:芯片面積與封裝面積之比,這個(gè)比值越接近1越好。
▍封裝時(shí)主要考慮的因素:
芯片面積與封裝面積之比,為提高封裝效率,盡量接近1:1。
引腳要盡量短以減少延遲,引腳間的距離盡量遠(yuǎn),以保證互不干擾,提高性能。
基于散熱的要求,封裝越薄越好。
▍封裝大致經(jīng)過了如下發(fā)展進(jìn)程:
結(jié)構(gòu)方面。TO→DIP→PLCC→QFP→BGA→CSP。
材料方面。金屬、陶瓷→陶瓷、塑料→塑料。
引腳形狀。長引線直插→短引線或無引線貼裝→球狀凸點(diǎn)。
裝配方式。通孔插裝→表面組裝→直接安裝。
▍以下為具體的封裝形式介紹:
SOP/SOIC封裝
SOP是英文Small Outline Package的縮寫,即小外形封裝。
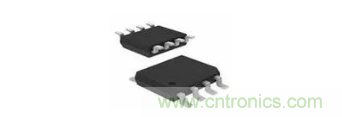
SOP封裝
SOP封裝技術(shù)由1968~1969年菲利浦公司開發(fā)成功,以后逐漸派生出:
SOJ,J型引腳小外形封裝
TSOP,薄小外形封裝
VSOP,甚小外形封裝
SSOP,縮小型SOP
TSSOP,薄的縮小型SOP
SOT,小外形晶體管
SOIC,小外形集成電路

DIP封裝
DIP是英文“Double In-line Package”的縮寫,即雙列直插式封裝。
DIP封裝
插裝型封裝之一,引腳從封裝兩側(cè)引出,封裝材料有塑料和陶瓷兩種。DIP是最普及的插裝型封裝,應(yīng)用范圍包括標(biāo)準(zhǔn)邏輯IC,存貯器LSI,微機(jī)電路等。
PLCC封裝
PLCC是英文“Plastic Leaded Chip Carrier”的縮寫,即塑封J引線芯片封裝。

PLCC封裝
PLCC封裝方式,外形呈正方形,32腳封裝,四周都有管腳,外形尺寸比DIP封裝小得多。PLCC封裝適合用SMT表面安裝技術(shù)在PCB上安裝布線,具有外形尺寸小、可靠性高的優(yōu)點(diǎn)。
04TQFP封裝
TQFP是英文“Thin Quad Flat Package”的縮寫,即薄塑封四角扁平封裝。四邊扁平封裝工藝能有效利用空間,從而降低對(duì)印刷電路板空間大小的要求。

TQFP封裝
由于縮小了高度和體積,這種封裝工藝非常適合對(duì)空間要求較高的應(yīng)用,如PCMCIA卡和網(wǎng)絡(luò)器件。幾乎所有ALTERA的CPLD/FPGA都有TQFP封裝。
PQFP封裝
PQFP是英文“Plastic Quad Flat Package”的縮寫,即塑封四角扁平封裝。

PQFP封裝
PQFP封裝的芯片引腳之間距離很小,管腳很細(xì)。一般大規(guī)?;虺笠?guī)模集成電路采用這種封裝形式,其引腳數(shù)一般都在100以上。
TSOP封裝
TSOP是英文“Thin Small Outline Package”的縮寫,即薄型小尺寸封裝。TSOP內(nèi)存封裝技術(shù)的一個(gè)典型特征就是在封裝芯片的周圍做出引腳。TSOP適合用SMT(表面安裝)技術(shù)在PCB上安裝布線。

TSOP封裝
TSOP封裝外形,寄生參數(shù)(電流大幅度變化時(shí),引起輸出電壓擾動(dòng))減小,適合高頻應(yīng)用,操作比較方便,可靠性也比較高。
BGA封裝
BGA是英文“Ball Grid Array Package”的縮寫,即球柵陣列封裝。20世紀(jì)90年代,隨著技術(shù)的進(jìn)步,芯片集成度不斷提高,I/O引腳數(shù)急劇增加,功耗也隨之增大,對(duì)集成電路封裝的要求也更加嚴(yán)格。為了滿足發(fā)展的需要,BGA封裝開始被應(yīng)用于生產(chǎn)。

BGA封裝
采用BGA技術(shù)封裝的內(nèi)存,可以使內(nèi)存在體積不變的情況下內(nèi)存容量提高兩到三倍,BGA與TSOP相比,具有更小的體積,更好的散熱性和電性能。BGA封裝技術(shù)使每平方英寸的存儲(chǔ)量有了很大提升,采用BGA封裝技術(shù)的內(nèi)存產(chǎn)品在相同容量下,體積只有TSOP封裝的三分之一。另外,與傳統(tǒng)TSOP封裝方式相比,BGA封裝方式有更加快速和有效的散熱途徑。
BGA封裝的I/O端子以圓形或柱狀焊點(diǎn)按陣列形式分布在封裝下面,BGA技術(shù)的優(yōu)點(diǎn)是I/O引腳數(shù)雖然增加了,但引腳間距并沒有減小反而增加了,從而提高了組裝成品率。雖然它的功耗增加,但BGA能用可控塌陷芯片法焊接,從而可以改善它的電熱性能。厚度和重量都較以前的封裝技術(shù)有所減少;寄生參數(shù)減小,信號(hào)傳輸延遲小,使用頻率大大提高;組裝可用共面焊接,可靠性高。
TinyBGA封裝
說到BGA封裝,就不能不提Kingmax公司的專利TinyBGA技術(shù)。TinyBGA英文全稱為“Tiny Ball Grid”,屬于是BGA封裝技術(shù)的一個(gè)分支,是Kingmax公司于1998年8月開發(fā)成功的。其芯片面積與封裝面積之比不小于1:1.14,可以使內(nèi)存在體積不變的情況下內(nèi)存容量提高2~3倍。與TSOP封裝產(chǎn)品相比,其具有更小的體積、更好的散熱性能和電性能。
采用TinyBGA封裝技術(shù)的內(nèi)存產(chǎn)品,在相同容量情況下體積,只有TSOP封裝的1/3。TSOP封裝內(nèi)存的引腳是由芯片四周引出的,而TinyBGA則是由芯片中心方向引出。這種方式有效地縮短了信號(hào)的傳導(dǎo)距離,信號(hào)傳輸線的長度僅是傳統(tǒng)的TSOP技術(shù)的1/4,因此信號(hào)的衰減也隨之減少。這樣不僅大幅提升了芯片的抗干擾、抗噪性能,而且提高了電性能。采用TinyBGA封裝芯片可抗高達(dá)300MHz的外頻,而采用傳統(tǒng)TSOP封裝技術(shù)最高只可抗150MHz的外頻。
TinyBGA封裝的內(nèi)存其厚度也更薄(封裝高度小于0.8mm),從金屬基板到散熱體的有效散熱路徑僅有0.36mm。因此,TinyBGA內(nèi)存擁有更高的熱傳導(dǎo)效率,非常適用于長時(shí)間運(yùn)行的系統(tǒng),穩(wěn)定性極佳。
QFP封裝
QFP是“Quad Flat Package”的縮寫,即小型方塊平面封裝。QFP封裝在早期的顯卡上使用的比較頻繁,但少有速度在4ns以上的QFP封裝顯存,因?yàn)楣に嚭托阅艿膯栴},目前已經(jīng)逐漸被TSOP-II和BGA所取代。QFP封裝在顆粒四周都帶有針腳,識(shí)別起來相當(dāng)明顯。四側(cè)引腳扁平封裝。表面貼裝型封裝之一,引腳從四個(gè)側(cè)面引出呈海鷗翼(L)型。
QFP封裝
基材有陶瓷、金屬和塑料三種。從數(shù)量上看,塑料封裝占絕大部分。當(dāng)沒有特別表示出材料時(shí),多數(shù)情況為塑料QFP。塑料QFP是最普及的多引腳LSI封裝,不僅用于微處理器,門陳列等數(shù)字邏輯LSI電路,而且也用于VTR信號(hào)處理、音響信號(hào)處理等模擬LSI電路。
引腳中心距有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm等多種規(guī)格,0.65mm中心距規(guī)格中最多引腳數(shù)為304。






