【導讀】為以16納米以下的制程節(jié)點生產(chǎn)IC設備,半導體制造商整合了許多新技術,包括多重圖形、隔離層間距分割、3D邏輯與內(nèi)存結構、新材料與復雜光罩。與這些創(chuàng)新技術相關的挑戰(zhàn)為半導體業(yè)界帶來了巨大的成本壓力。在這樣的環(huán)境中,高良率與快速提升良率在幫助半導體制造商保持盈利能力方面至關重要。
制程控制(process control)在過去30年,透過提供早期識別嚴重制程問題所需的檢測與度量技術幫助IC制造商提升良率。隨著IC設備設計節(jié)點隨時間收縮,制程控制系統(tǒng)透過實現(xiàn)支持檢測抑制良率與可靠性的缺陷及制程變化的創(chuàng)新技術跟上步伐。
例如KLA-Tencor的光學晶圓檢測系統(tǒng)在過去的30年已從使用鎢鹵素(tungsten-halogen)光源、現(xiàn)成的顯微物鏡和傳感器,發(fā)展成利用比太陽更亮的雷射激發(fā)寬帶光源、與步進機應用相同復雜的光學組件,以及比數(shù)字相機快1,000倍的客制化傳感器。
目前的寬帶電漿光學圖形化晶圓檢測設備,能夠檢測到10納米的缺陷─那只比DNA鏈的直徑大四倍;要在12吋(300mm)晶圓片上的所有晶粒中檢測這些缺陷,困難度相當于在像是美國加州那么大的區(qū)域范圍中,尋找散落距離可達數(shù)英哩的數(shù)百個硬幣─而且是在1小時之內(nèi)。
用于生產(chǎn)目前尖端設備的多種技術為制程控制帶來了挑戰(zhàn)。檢測與度量系統(tǒng)需能從較小的缺陷和制程/圖樣變化中擷取訊號,這些擷取通常在具有高長寬比特征的復雜 3D結構上進行。隨著新材料的使用和制程變化性的增加,訊號擷取需要在背景噪聲更強的環(huán)境中進行。此外,隨著使用多重圖形和更多的制程步驟,檢測與度量工 具需要提高生產(chǎn)率,以便能執(zhí)行足夠用于檢測偏差的生產(chǎn)監(jiān)控。
例如,使用多重圖形技術生 產(chǎn)的FinFET晶體管需要使用借助于先進檢測和度量系統(tǒng)的制程控制策略,這些系統(tǒng)整合了設計信息并能夠產(chǎn)生應對較小的嚴重缺陷、3D結構和窄制程容許范圍(process window)所需的靈敏度。此外,檢測與度量解決方案也必須提高生產(chǎn)率,以便經(jīng)濟有效地監(jiān)控使用多重圖形制造FinFET晶體管相關的、越來越多的制程步驟。
這些挑戰(zhàn)推動了創(chuàng)新,催生能早期發(fā)現(xiàn)設計、圖形化或制程問題的獨特制程控制技術和解決方案;這類方案對于IC制造商至關重要,因為它能夠?qū)崿F(xiàn)今日的尖端技術,以及未來能以更低風險與成本達到最大化提升良率與組件性能的技術。
制程控制的價值
做為制程控制核心的檢測與度量系統(tǒng)并不是用來制造IC設備,因為它們不會添加/移除材料或者制作圖形;但制程控制對制造具備高良率的可靠組件至關重要,并非多余步驟。
透過查找缺陷和測量關鍵參數(shù),檢測與度量系統(tǒng)可監(jiān)控制造組件所需的數(shù)百個步驟。這些制程控制措施可幫助晶圓廠的工程師在出現(xiàn)偏差時確定制程問題并解決問題。制程控制從根本上與良率相關聯(lián),因為晶圓廠不透過檢測與度量,幾乎無法查明影響良率的制程問題。
快速提高良率從而快速將產(chǎn)品推向市場,對芯片制造商至關重要─良率提升有任何延誤都會影響營收,并有可能影響用于研發(fā)的未來投資以及下一代產(chǎn)品的發(fā)表。透過實施諸如強大的制程控制策略等步驟,晶圓廠能縮短開發(fā)時間、加快生產(chǎn)速度和提高產(chǎn)品良率。
事實上,芯片制造商可從制程控制獲得的價值有多種形式,包括:強大的投資回報、更低的制造成本與風險、更高的營收、更快的獲利速度、改善的產(chǎn)品周期、更高的利潤以及業(yè)務連貫性。
為讓讀者對制程控制價值有更進一步了解,我們收集了“制程控制的十個基本事實”(圖1)。透過這十個事實來了解制程控制的基本特性,晶圓廠可以實施用于確定嚴重缺陷、查找偏差和減少變異來源的策略。

圖1 制程控制對半導體 IC 產(chǎn)業(yè)的十個基本事實。
有鑒于先進組件和制程整合日益升高的復雜度,晶圓廠在發(fā)展時必須考慮的最關鍵的事實為:制程控制需求會隨著設計規(guī)則演進而增加。如圖 2所示,制程步驟數(shù)量從16/14納米節(jié)點開始急遽增加;隨著制程步驟的增加,所有步驟都必須為偏差、缺陷密度和變化性設定更高的標準。
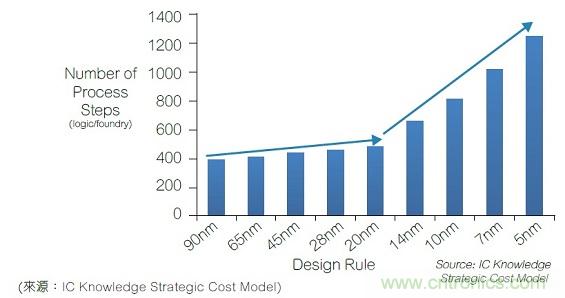
圖2 制程步驟從16/14納米節(jié)點開始隨設計規(guī)則微縮而急遽增加。
若每一個步驟的良率均保持在28納米節(jié)點的水平,那么每個較小設計節(jié)點的預測累積良率將降低(圖3)。考慮到這種良率損失的復合性質(zhì),晶圓廠須在每個獨立的制程步驟中保持更嚴格的控制和更低的缺陷密度。

圖3 隨著制程步驟的增加,如果每步驟良率均保持在28納米的水平,則先進設計節(jié)點的預測累計良率將降低。
這驅(qū)動對新制程控制策略的需要,這些策略不僅可檢測出嚴重影響良率的缺陷和微妙的制程變化,還可讓工程師增加檢測與度量樣本。此類制程控制能力支持對越來越多制程步驟的直接監(jiān)測,以及快速檢測對晶圓制造成本具有顯著影響的偏差。
應對未來制程控制挑戰(zhàn)的策略
在朝16納米以下設計節(jié)點進軍時,半導體制造商面臨摩爾定律(Moore''s Law)的諸多挑戰(zhàn)。在技術層面上,存在與整合新技術相關的諸多復雜因素(如多重圖形、3D結構、新材料、復雜光罩、制程步驟的數(shù)量增加)。在經(jīng)濟層面 上,這些多種技術融合讓晶圓廠控制成本的壓力更大;晶體管成本與比例因子(scaling factor)、制造成本和良率有關。隨著制造、設計、開發(fā)和微影成本的增加,半導體制造商取得摩爾定律成本目標的最佳解決方案為快速提升良率。
在嘗試快速提升良率時,IC制造商必須克服圍繞設計強韌度與制程容許范圍的諸多問題。在設計層面上,工程師必須能夠發(fā)現(xiàn)和評估設計缺點,以便推動改進,從而確保設備設計與制造技術在生產(chǎn)中是穩(wěn)定的。
在 16納米以下的設計節(jié)點中,所需的圖形重迭預算(pattern overlay budget)為小于等于4.5納米,臨界尺寸規(guī)格為~2納米,制程容許范圍極窄。為推動滿足這些嚴格的圖形化規(guī)格(圖4)所需的變更,工程師需要了解圖 形化錯誤的整廠性來源(fab-wide sources)和變異性對制程容許范圍的影響。

圖4 對于先進多重圖形技術,圖形化錯誤的來源是整廠性的─同時發(fā)生在微影單元的內(nèi)部與外部。為滿足極為嚴格的重迭與臨界尺寸規(guī)格,工程師必須設法減少制程變化的整廠性來源。
對于在成本目標中應對復雜技術挑戰(zhàn)的這一環(huán)境,制程控制至關重要。開發(fā)必要的制程控制解決方案具有挑戰(zhàn)─這需要巨大的創(chuàng)新和在半導體業(yè)界多個部門之間的密切 協(xié)作。這不僅對開發(fā)可提供先進的檢測與度量系統(tǒng)效能的新技術很重要,也對追求朝向全面性制程控制解決方案的創(chuàng)新至關重要─這些策略將制程控制系統(tǒng)結合在一 起,從而使它們可以在晶圓廠中連同智能分析系統(tǒng)共同處理所產(chǎn)生的大量復雜資料。這些制程控制“系統(tǒng)中的系統(tǒng)”,可幫助晶圓廠透過快速設計驗證和制程容許范圍發(fā)現(xiàn)、擴展和控制快速提升良率。
缺陷發(fā)現(xiàn)的目標為檢測和識別嚴重影響良率的缺陷,以突顯開發(fā)階段的設計問題和生產(chǎn)階段的制程漂移。發(fā)現(xiàn)系統(tǒng)(discovery system)憑借寬帶電漿光學缺陷檢測系統(tǒng)上的NanoPoin技術利用設計信息發(fā)現(xiàn)最嚴重影響良率的圖樣缺陷。
Surfscan SP5無圖形(unpatterned)晶圓檢測系統(tǒng)透過檢測微小的原片缺陷來幫助避免良率問題,這些缺陷可能扭曲先進3D組件(如FinFET晶體管和 垂直NAND閃存)的后續(xù)薄膜與圖形結構。最后,eDR-7110電子束審查與分類系統(tǒng)可以確定2920系列與Surfscan檢測器所檢測到的缺 陷。透過生成有關嚴重納米級缺陷的綜合信息,缺陷發(fā)現(xiàn)解決方案可幫助晶圓廠的工程師描述、優(yōu)化和監(jiān)控先進制程,以便縮短上市時間。
5D 圖形化解決方案的目標是幫助IC制造商在先進組件上實現(xiàn)最佳的圖形化。借助目前復雜的多重圖形與隔離層間距分割技術,圖形化錯誤不再與微影單元有關。圖形 化錯誤可能來自整廠性來源,如與掃描儀焦點錯誤直接有關的CMP所導致的晶圓變形。5D解決方案利用多種類型的度量系統(tǒng)來確定和控制圖形化變異的整廠性來源,并透過智能分析系統(tǒng)來處理產(chǎn)生的數(shù)據(jù)。
該系統(tǒng)解決方案的關鍵組成部分為回饋(feed back)和前饋(feed forward)度量資料能力(圖5)。回饋回路已用于多個設計節(jié)點。

圖 5 KLA-Tencor的5D圖形化控制解決方案透過實施多個數(shù)據(jù)回路來幫助優(yōu)化圖形化?,F(xiàn)有的回饋回路(藍)已存在于多個設計節(jié)點中,并對制程變化進行檢測和補償。經(jīng)過優(yōu)化的新回饋回路(綠)可以更早地偵測制程變化。創(chuàng)新的前饋回路(橙)利用度量系統(tǒng)從源頭測量變更,然后將該數(shù)據(jù)前饋至后續(xù)制程步驟。
這種利用整廠性全面測量值與智能回饋組合以及前饋控制回路的5D解決方案,可幫助晶圓廠的工程師擴大制程容許范圍并減輕這些窗口中的變化,最終獲得更好的圖形化結果。
這些綜合制程控制解決方案對IC業(yè)界的成功至關重要,它們透過使工程師可以更快和更經(jīng)濟有效地解決廣泛的制程問題來實現(xiàn)高良率并快速提高良率。在發(fā)展時必須維持創(chuàng)新與協(xié)作生態(tài)系統(tǒng),以確??梢蚤_發(fā)出能夠應對IC制程與成本挑戰(zhàn)的新制程控制系統(tǒng)與解決方案。
【推薦閱讀】






