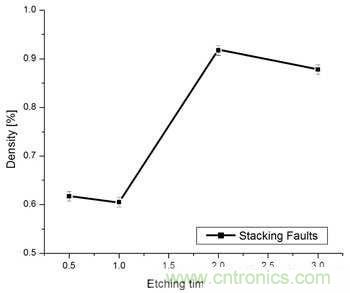
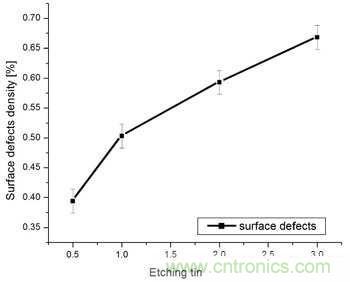


發(fā)布時(shí)間:2016-08-30 責(zé)任編輯:susan
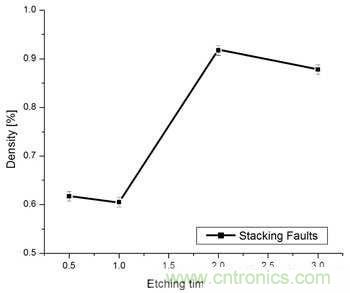
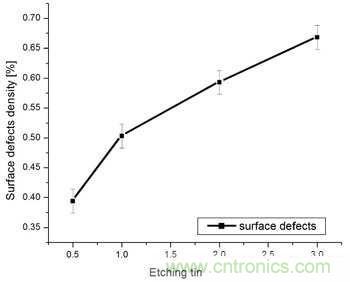


我愛方案網(wǎng) ICGOO元器件商城 創(chuàng)芯在線檢測 芯片查詢 天天IC網(wǎng) 電子產(chǎn)品世界 無線通信模塊 控制工程網(wǎng) 電子開發(fā)網(wǎng) 電子技術(shù)應(yīng)用 與非網(wǎng) 世紀(jì)電源網(wǎng) 21ic電子技術(shù)資料下載 電源網(wǎng) 電子發(fā)燒友網(wǎng) 中電網(wǎng) 中國工業(yè)電器網(wǎng) 連接器 礦山設(shè)備網(wǎng) 工博士 智慧農(nóng)業(yè) 工業(yè)路由器 天工網(wǎng) 乾坤芯 電子元器件采購網(wǎng) 亞馬遜KOL 聚合物鋰電池 工業(yè)自動(dòng)化設(shè)備 企業(yè)查詢 工業(yè)路由器 元器件商城 連接器 USB中文網(wǎng) 今日招標(biāo)網(wǎng) 塑料機(jī)械網(wǎng) 農(nóng)業(yè)機(jī)械 中國IT產(chǎn)經(jīng)新聞網(wǎng) 高低溫試驗(yàn)箱
關(guān)閉
關(guān)閉