【導(dǎo)讀】本文將探討如何在雪崩工作條件下評估SiC MOSFET的魯棒性。MOSFET功率變換器,特別是電動(dòng)汽車驅(qū)動(dòng)電機(jī)功率變換器,需要能夠耐受一定的工作條件。如果器件在續(xù)流導(dǎo)通期間出現(xiàn)失效或柵極驅(qū)動(dòng)命令信號錯(cuò)誤,就會(huì)致使變換器功率開關(guān)管在雪崩條件下工作。因此,本文通過模擬雪崩事件,進(jìn)行非鉗位感性負(fù)載開關(guān)測試,并使用不同的SiC MOSFET器件,按照不同的測試條件,評估技術(shù)的失效能量和魯棒性。
引語
能效和可靠性是所有電子功率變換器必備的主要特性。在與人類社會(huì)活動(dòng)和生態(tài)環(huán)境保護(hù)相關(guān)的應(yīng)用領(lǐng)域,例如,交通、工業(yè)、能源轉(zhuǎn)換等,標(biāo)準(zhǔn)硅基功率開關(guān)管已被SiC MOSFET取代,因?yàn)镾iC MOSFET在電流密度/芯片面積、擊穿電壓、開關(guān)頻率、工作溫度方面表現(xiàn)更出色,可縮減功率變換器的體積和尺寸,同時(shí)提高能效[1],[2]。
采用最新一代SiC MOSFET設(shè)計(jì)功率變換器應(yīng)該認(rèn)真考慮器件的可靠性和魯棒性,避免讓異常失效現(xiàn)象破壞系統(tǒng)的整體安全性[3],[4]。短路和雪崩是可能導(dǎo)致電源轉(zhuǎn)換器開關(guān)管嚴(yán)重失效的異常事件[5] [6]。
短路事件可能是錯(cuò)誤和失控的工作條件引起的,例如,器件開關(guān)順序命令出錯(cuò)。當(dāng)漏源電壓VDS超過擊穿電壓額定值時(shí),會(huì)發(fā)生雪崩事件[7]。
對于dvDS/dt 和diD/dt變化率很高的應(yīng)用,在開關(guān)瞬變期間,VDS可能會(huì)超過擊穿電壓額定值。高瞬變率結(jié)合變換器布局固有的寄生電感,將會(huì)產(chǎn)生電壓尖峰,在極端情況下,導(dǎo)致雪崩事件發(fā)生[7],[14],[16]。SiC MOSFET可能會(huì)出現(xiàn)這些工作條件,分立器件的dvDS/dt可能輕松超過100V/ns,diD/dt超過10A/ns[1],[21]。
另一方面,電機(jī)功率變換器也是一個(gè)值得關(guān)注的重點(diǎn),例如,電動(dòng)汽車的驅(qū)動(dòng)電機(jī)逆變器、工業(yè)伺服電機(jī)等,這些應(yīng)用的負(fù)載具有典型的電感特性,要求功率開關(guān)還必須兼?zhèn)淅m(xù)流二極管的功能[18]。因此,在二極管關(guān)斷時(shí),其余器件將傳導(dǎo)負(fù)載電流,進(jìn)行非鉗位感性負(fù)載開關(guān)UIS操作,工作于雪崩狀態(tài)是無法避免的[13]。在這種雪崩期間,除過電壓非常高之外,高耗散能量也是一個(gè)需要考慮的重要問題,因?yàn)槠骷仨毮褪墚惓5碾妷汉碗娏髦怠?/div>
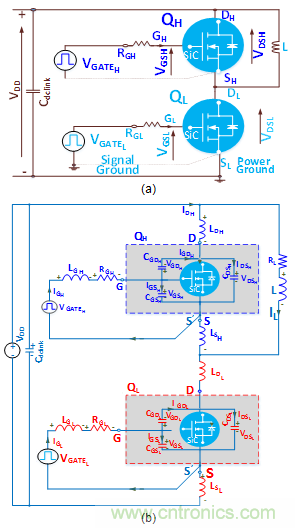
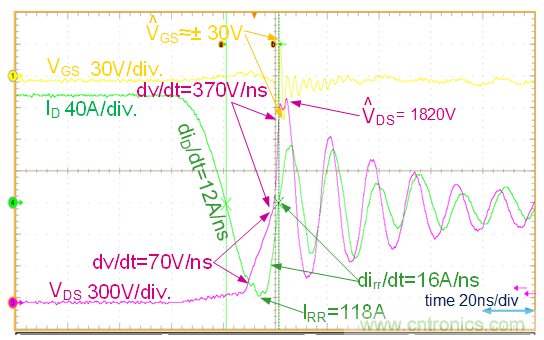
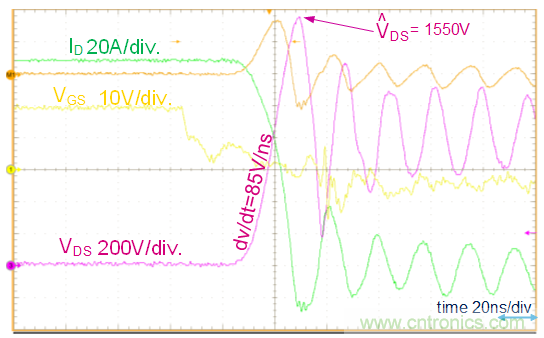

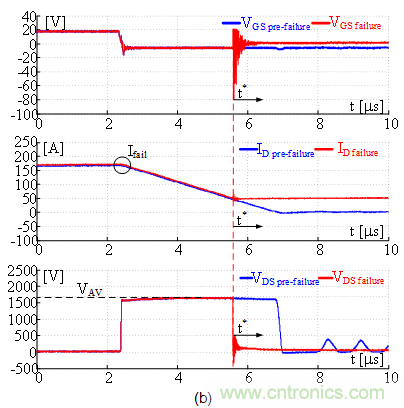

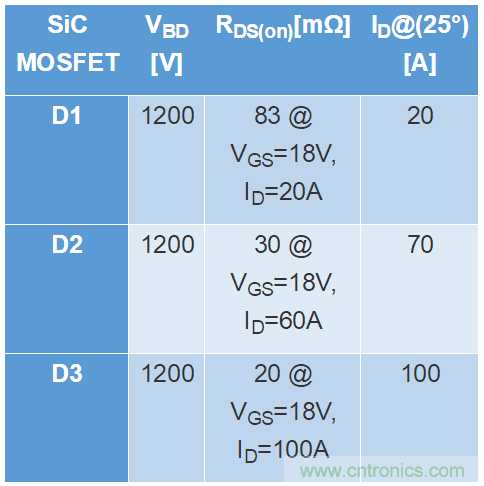

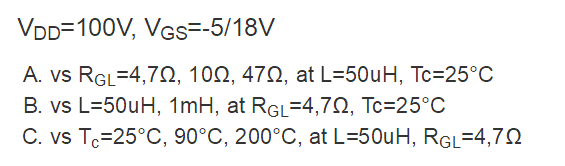

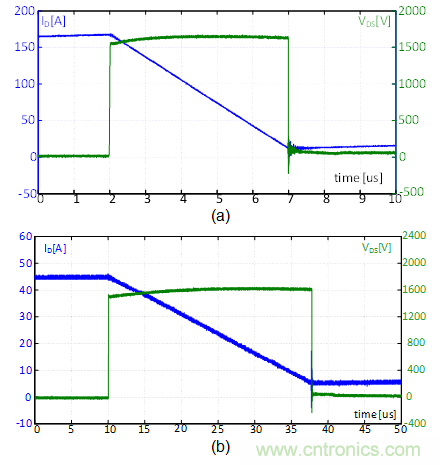
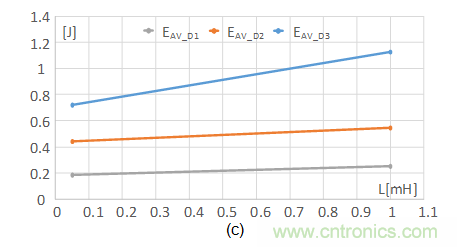

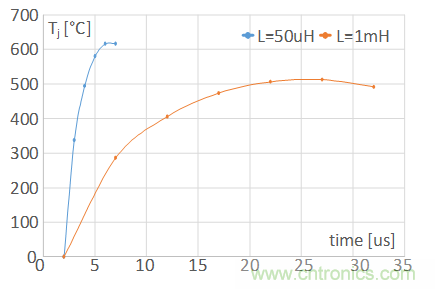
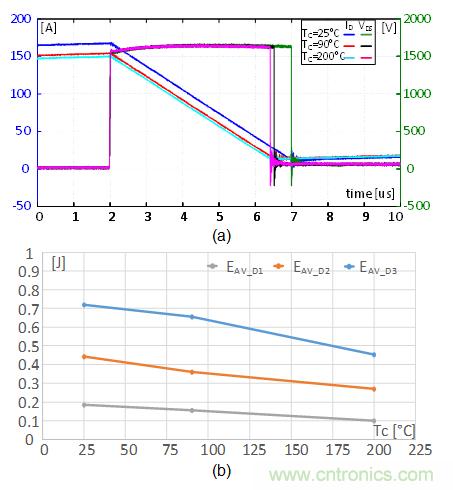
采用失效檢測算法和保護(hù)系統(tǒng),配合同樣基于“可靠性”標(biāo)準(zhǔn)的變換器設(shè)計(jì)方法,是很有必要的[20]。但是,除了安全保護(hù)和最佳設(shè)計(jì)規(guī)則外,功率開關(guān)管還必須強(qiáng)健結(jié)實(shí),即具有“魯棒性”,才能耐受某種程度的異常工作條件,因?yàn)榧幢愠焖贆z測算法和保護(hù)系統(tǒng)也無法立即發(fā)揮作用[19]。SiC MOSFET的雪崩問題已成為一個(gè)重要的專題,由于該技術(shù)尚未完全成熟,因此需要進(jìn)行專門的研究[7]-[13]。
本文的目的是分析SiC MOSFET在雪崩工作條件下的魯棒性。為了驗(yàn)證魯棒性分析結(jié)果,我們做了許多實(shí)驗(yàn)。最后,我們介紹了器件在不同的UIS測試條件下的魯棒性。
雪崩事件
通常來說,雪崩事件只有在器件達(dá)到擊穿電壓時(shí)才會(huì)發(fā)生。在正常工作條件下,凡是設(shè)置或要求高開關(guān)頻率的應(yīng)用都會(huì)發(fā)生這種現(xiàn)象。
以基于半橋轉(zhuǎn)換器的應(yīng)用為例,讓我們詳細(xì)解釋一下雪崩現(xiàn)象。
圖1(a)是一個(gè)簡化的半橋轉(zhuǎn)換器電路原理圖,電路中有兩個(gè)SiC MOSFET開關(guān)管,分別用QH和QL表示,除開關(guān)管外,還有一個(gè)感性負(fù)載;圖1(b)是上面電路的等效電路圖,最重要的部分是主要寄生元件,特別是代表電源回路等效寄生電感的LDH,LSH,LDL和LSL,電源回路是指連接+ DC電路(VDD)與QH漏極,QH源極至QL漏極,QL源極至-DC電路的電源軌。此外,LGH,LGL是QH和QL的柵極-源極路徑信號回路的等效寄生電感。考慮到HiP247封裝分立器件有三或四個(gè)引線,上面的寄生電感中包含SiC MOSFET焊線和引線的寄生電感,詳細(xì)信息參見[15],[16]。同樣重要的是,還要考慮SiC MOSFET的寄生電容CGS,CDS和CGD,這些參數(shù)是漏極-源極電壓VDS的函數(shù)[21]。
不難理解在下面兩個(gè)案例的極端工作條件期間產(chǎn)生的電壓尖峰:
1) 有源器件導(dǎo)通,無源器件的體二極管關(guān)斷
2) 有源器件關(guān)斷,無源器件的體二極管導(dǎo)通
用1200V,25mΩ,HIP247-4L封裝的SiC MOSFET分立器件,按照圖1的方案做實(shí)驗(yàn)測試,描述瞬變在什么情況下被定義為極端工作條件。為簡單起見,將QL視為有源器件,它由適合的柵極驅(qū)動(dòng)器電路控制;QH是無源器件,用作續(xù)流二極管,并且通常在相關(guān)終端施加-5V的恒定負(fù)柵極-源極電壓。
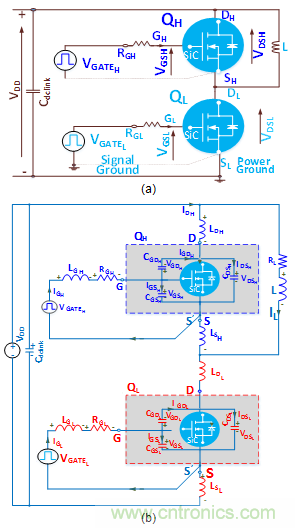
圖1:半橋轉(zhuǎn)換器橋臂:(a)簡化框圖,(b)包括主要寄生元件的等效電路。
通過分析圖2的實(shí)驗(yàn)結(jié)果,可以知曉案例1)的極端工作條件。
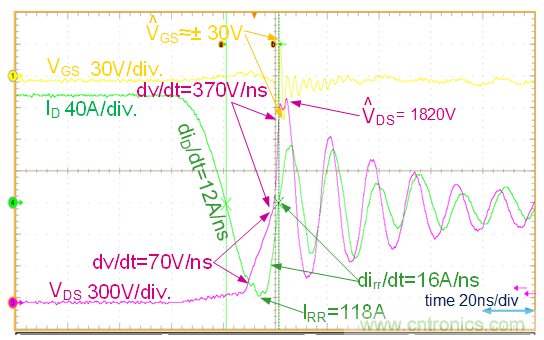
圖2:在850V, 130A,QH體二極管關(guān)斷時(shí),VGS, ID和VDS的典型波形。
本節(jié)重點(diǎn)介紹在QL導(dǎo)通時(shí)QH體二極管的“反向恢復(fù)”過程。測試條件是175°C,VDD=850V, ID=130A。SiC MOSFET的反向恢復(fù)過程是一個(gè)重要的課題,許多人都在研究這種現(xiàn)象[17],[18]。軟恢復(fù)和硬恢復(fù)模式受載流子壽命、摻雜分布、裸片面積等因素影響。從應(yīng)用角度來看,反向恢復(fù)特性主要與正向電流大小ID及其變化率diD/dt和工作溫度有關(guān)。圖2顯示了變化速率12A/ns 的ID引起的QH體二極管硬恢復(fù)特性。由于結(jié)耗盡非常快,漏極-源極電壓VDS以最快的速度上升。在diD/dt 和dirr/dt與寄生電感的綜合作用下,尖峰電壓現(xiàn)象嚴(yán)重,并且在VDS波形上看到振蕩行為。另外,VGS波形出現(xiàn)明顯振蕩,應(yīng)鉗制該電壓,以避免雜散導(dǎo)通[16]。
快速恢復(fù)用于描述恢復(fù)的效果,概念定義詳見文獻(xiàn)[17]。
通過優(yōu)化轉(zhuǎn)換器電路板布局,將寄生電感降至非常低,可以限制在電流變化率非常高的關(guān)斷期間產(chǎn)生的電壓尖峰,從而最大程度地利用SiC MOSFET的性能。
圖3的實(shí)驗(yàn)測試結(jié)果解釋了案例2)的極端工作條件。圖中所示是在室溫(25°C),850V,130A條件下QL“關(guān)斷”時(shí)的相關(guān)參數(shù)波形。因?yàn)槠骷捎肏IP247-4L封裝,3.3?的柵極電阻Rg加快了關(guān)斷瞬變,并且VDS的峰值非常高(約1550V)。
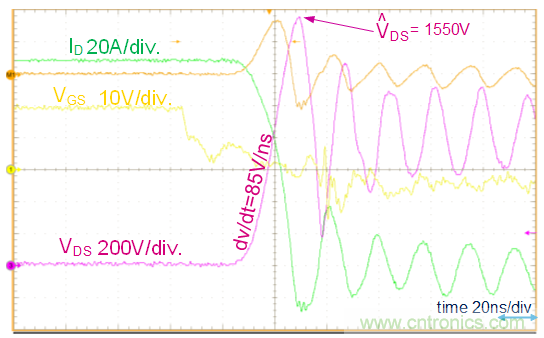
圖3:在850V, 130A條件下關(guān)斷QL,VGS, ID, VDS 和Poff的典型波形。
通過進(jìn)一步降低Rg阻值提高關(guān)斷速度,將會(huì)引發(fā)雪崩事件,不過,在本實(shí)驗(yàn)報(bào)告中沒有達(dá)到雪崩狀態(tài)。
但是,除極端工作條件外,元器件失效也會(huì)導(dǎo)致雪崩事件[4]。
以前文提到的圖1半橋轉(zhuǎn)換器為例,當(dāng)QH續(xù)流二極管失效,致使器件關(guān)斷時(shí),負(fù)載電流必須在關(guān)斷瞬變期間流經(jīng)互補(bǔ)器件QL,這個(gè)過程被稱為非鉗位感性負(fù)載開關(guān)UIS。在這個(gè)事件期間,器件必須承受某種程度的能量,直到達(dá)到QL擊穿極限值為止。
這種失效機(jī)制與臨界溫度和熱量產(chǎn)生有關(guān)。SiC MOSFET沒有硅基器件上發(fā)現(xiàn)的其它失效模式,例如,BJT閂鎖[10]。在UIS條件下的雪崩能量測試結(jié)果被用于定義SiC MOSFET的魯棒性。
圖4(a)和圖4(b)是SiC MOSFET的UIS測試結(jié)果。這些測試是在圖1無QH的配置中做的,測試條件是VDD=100V, VGS=-5/18V, RGL=4,7?, L=50?H, Tc=25°C,下一章詳細(xì)解釋這樣選擇的原因。
圖4(a)所示是前三次脈沖測試。QL正在傳導(dǎo)電流,在第一個(gè)脈沖時(shí)關(guān)斷,如圖中藍(lán)色的VGS,VDS和ID的波形所示,有過電壓產(chǎn)生,VDS略低于1500V,但器件沒有雪崩。在增加脈沖周期后,如圖中綠色波形所示,電流ID達(dá)到5A,器件開始承受雪崩電壓。再重復(fù)做一次UIS測試,如黑色波形所示,電流值變大,但由于負(fù)載電感器較小,直到電流值非常大時(shí)才達(dá)到失效能量。

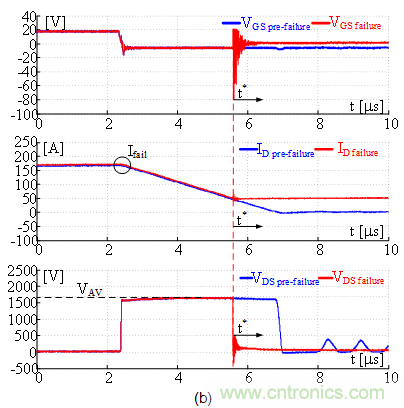
圖4:UIS實(shí)驗(yàn),(a)雪崩過程開始時(shí)的波形;(b)施加最后兩個(gè)脈沖時(shí)的波形。
圖4(b)所示是最后一種情況的測試結(jié)果。藍(lán)色波形是在一系列單脈沖后,器件失效前倒數(shù)第二個(gè)脈沖產(chǎn)生的波形,從圖中可以看到,器件能夠處理關(guān)斷瞬變,耐受根據(jù)下面的雪崩能量公式(1)算出的約0,7J雪崩能量,最大漏極電流為170A,雪崩電壓平均值為1668V。

紅色波形是在施加最后一個(gè)脈沖獲得的失效波形,這時(shí)器件不再能夠耐受雪崩能量,并且在t *時(shí)刻發(fā)生失效,漏極電流開始驟然增加。
魯棒性評估和雪崩測試
我們用三組1200V SiC MOSFE做了UIS測試,表1列出了這三組器件的主要數(shù)據(jù)。
5(a)所示是測試等效電路圖,5(b)所示是相關(guān)實(shí)驗(yàn)裝置。QL是待測器件(DUT),測試目標(biāo)是分析DUT的關(guān)斷特性。
表1:SiC MOSFET規(guī)格
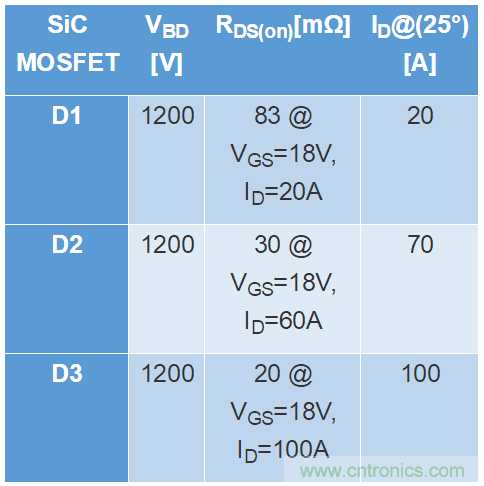

圖5:UIS實(shí)驗(yàn)裝置: (a)等效電路, (b) 實(shí)驗(yàn)臺(tái)
設(shè)置A,B,C三種測試條件;施加周期遞增的單脈沖序列,直到待測器件失效為止。
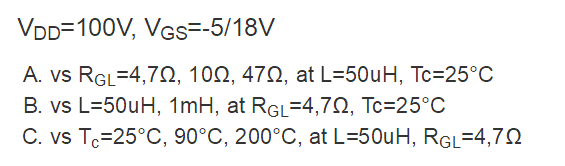
為了便于統(tǒng)計(jì),從D1,D2和D3三組器件中分別抽出五個(gè)樣品,按照每種測試條件各做一次UIS實(shí)驗(yàn),測量和計(jì)算失效電流和失效能量,參見圖6,圖7和圖8。
圖6(a)所示是從SiC MOSFET D3中抽出的一個(gè)典型器件,按照測試條件“A”做UIS測試的VDS和ID失效波形。

圖6:UIS對RG最終測試結(jié)果:(a)一個(gè)D3樣品的VDS和ID典型值;(b)平均失效能量EAV。
為了清楚起見,只給出了RG=4.7Ω和47Ω兩種情況的波形。我們觀察到,失效電流不受RGL的影響。圖6(b)顯示了D1,D2和D3三組的平均EAV。
注意到EAV失效能量略有降低,可忽略不計(jì),因此,可以得出結(jié)論,在UIS測試條件下,這些SiC MOSFET的魯棒性與RG無關(guān)。
圖7(a)和(b)所示是按照測試條件B,在L=50?H 和1mH時(shí),各做一次UIS測試的失效波形,為簡單起見,只從SiC MOSFET D3中抽取一個(gè)典型樣品做實(shí)驗(yàn)。
在提高負(fù)載電感后,電感器儲(chǔ)存的能量增加,因此,失效電流減小。
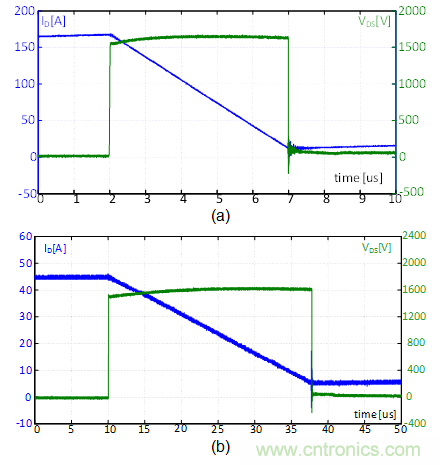
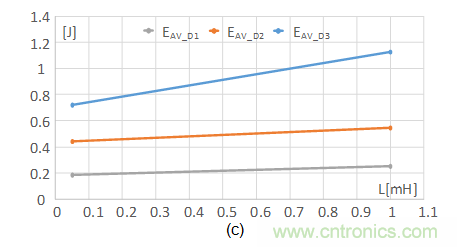
圖7:UIS對L最終測試結(jié)果(a) 在L=50?H時(shí), D3樣品的VDS和 ID典型值 (b)在L=1mH時(shí), D3樣品的VDS和 ID典型值 (c) 平均失效能量EAV.
圖7(c)顯示了D1,D2和D3的平均EAV與L的關(guān)系,可以觀察到,器件D3的失效能量EAV隨著負(fù)載電感提高而顯著提高,而D1和D2的EAV則略有增加。通過分析圖8可以發(fā)現(xiàn)這種行為特性的原因。圖8是根據(jù)等式(2)計(jì)算出來的結(jié)溫Tj的分布圖:

其中:T0是起始溫度,PAV是平均脈沖功率,Zth是芯片封裝熱阻,本次實(shí)驗(yàn)用的是不帶散熱器的TO247-3L封裝。
電感器儲(chǔ)存能量的大小與電感值有關(guān),儲(chǔ)存能量將被施加到裸片上,轉(zhuǎn)換成熱能被耗散掉。
如圖7(a)所示,低電感值會(huì)導(dǎo)致非常大的熱瞬變,這是因?yàn)殡娏髟趲孜⒚雰?nèi)就達(dá)到了非常高的數(shù)值,如圖7(a)所示,因此,結(jié)溫在UIS期間上升非???,但裸片沒有夠的時(shí)間散掉熱量。相反,在高電感值的情況下,電流值較低,如圖7(b)所示,并且裸片有足夠的時(shí)間散掉熱量,因此,溫度上升平穩(wěn)。
這個(gè)實(shí)驗(yàn)結(jié)果解釋了為什么被測器件D3的EAV隨負(fù)載電感提高而顯著增加的原因,另外,它的裸片面積比SiC MOSFET D1和D2都大。
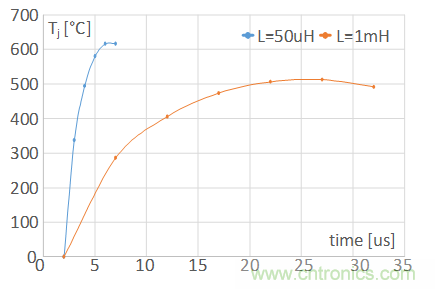
圖8:典型D3器件的估算結(jié)溫Tj對L曲線圖。
最后,在圖9中報(bào)告了測試條件C的UIS測試結(jié)果,測試條件C是封裝溫度的函數(shù),用熱電偶測量封裝溫度數(shù)值。
圖9(a)所示是D3在Tc=25°C,90℃和200℃三個(gè)不同溫度時(shí)的VDS和ID波形。不出所料,D1,D2和D3三條線的趨勢相似,工作溫度越高,引起器件失效的EAV就越低,圖9(b)。
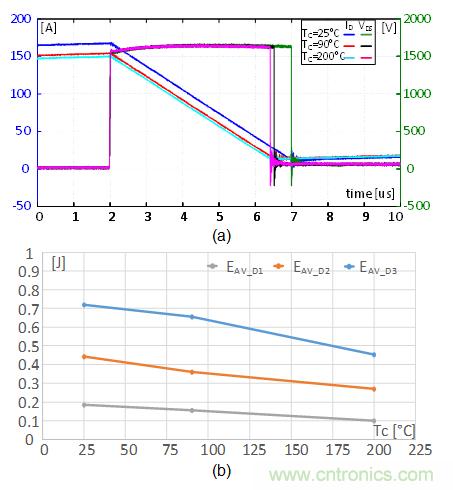
圖9:UIS對Tc的最終測試結(jié)果;(a)D3樣品在不同的Tc時(shí)的VDS和ID典型值;(b)平均失效能量EAV 對TC曲線
結(jié)論
本文探討了在SiC MOSFET應(yīng)用中需要考慮的可能致使功率器件處于雪崩狀態(tài)的工作條件。為了評估SiC MOSFET的魯棒性,本文通過實(shí)驗(yàn)測試評估了雪崩能量,最后還用三款特性不同的SiC MOSFET做對比測試,定義導(dǎo)致器件失效的最大雪崩能量。雪崩能量與芯片面積成正比,并且是柵極電阻、負(fù)載電感和外殼溫度的函數(shù)。
這種在分立器件上進(jìn)行的雪崩耐量分析,引起使用電源模塊開發(fā)應(yīng)用的設(shè)計(jì)人員的高度關(guān)注,因?yàn)殡娫茨K是由許多并聯(lián)芯片組成,這些芯片的魯棒性需要高度一致,必須進(jìn)行專門的測試分析。此外,對于特定的應(yīng)用,例如,汽車應(yīng)用,評估雪崩條件下的魯棒性,可以考慮使用單脈沖雪崩測試和重復(fù)雪崩測試方法。這是一個(gè)重點(diǎn)課題,將是近期評估活動(dòng)的目標(biāo)。
參考文獻(xiàn)
[1] F. Wang and Z. Zhang “Overview of Silicon Carbide Technology: Device, Converter, System, and Application,” Power Electr. And Appl. Trans on. CPSS, vol. 1, no. 1, pp. 13-32, December 2016.
[2] S. Ji, Z. Zhang, F. F. Wang “Overview of High Voltage SiC Power Semiconductor Devices: Development and Application,” CES Trans. On Elec. Machines and Systems, vol. 1, no. 3, Sept. 2017, pp.:254-264.
[3] B. Wang, J. Cai, X.Du and L. Zhou “Review of Power Semiconductor Device Reliability for Power Converters,” CPSS Trans. On Pow. Elect. and Appl. Vol.2, no.2, pp. 101-117, June2017.
[4] A. Hanif, Y. Yu, D. DeVoto and F.Khan “A Comprehensive Review Toward the State-of-the-Art in Failure and Lifetime Predictions of Power Electronic Devices,” IEEE Trans. On Pow. Elect. vol.34, no.5, pp. 4729- 4746May2019.
[5] B. Mirafzal “Survey of Fault-Tolerance Techniques for Three-Phase Voltage Source Inverters,” IEEE Trans. on Ind. Elec. Vol.61, no.10, pp. 5192-5202, Oct.2014.
[6] F. Richardeau, P. Baudesson, T. A. Meynard “Failures-Tolerance and Remedial Strategies of a PWM Multicell Inverter,” IEEE Trans. Power Elec., vol. 17, no. 6, pp 905-912, Nov.2002.
[7] A. Fayyaz, G. Romano, J. Urresti, M. Riccio, A. Castellazzi, A. Irace, and N. Wright, “A Comprehensive Study on the Avalanche Breakdown Robustness of Silicon Carbide Power MOSFETs”, Energies, vol. 10, no. 4, pp. 452-466, 2017.
[8] M. D. Kelley, B. N. Pushpakaran and Stephen B. Bayne “Single-Pulse Avalanche Mode Robustness of Commercial 1200 V/80 mΩ SiC MOSFETs,” IEEE Trans. On Pow. Elec. Vol. 32, no.8, pp. 6405-6415, Aug. 2017.
[9] I. Dchar, M. Zolkos, C. Buttay, H. Morel “Robustness of SiC MOSFET under Avalanche Conditions”, 2017 IEEE Applied Power Electronics Conference and Exposition (APEC)
[10] N. Ren, H. Hu, K. L. Wang, Z. Zuo, R. Li, K. Sheng “Investigation on Single Pulse Avalanche Failure of 900V SiC MOSFETs” Int. Symp. On Power Semic. Dev. & ICs, May 13-17, 2018.
[11] J. Wei, S. Liu, S. Li, J. Fang, T. Li, and W. Sun “Comprehensive Investigations on Degradations of Dynamic Characteristics for SiC Power MOSFETs under Repetitive Avalanche Shocks,” IEEE Trans. on Power Elec. Vol.: 34, no: 3, pp. 2748– 2757, March 2019
[12] J. Hu, O. Alatise, J. Angel Ortiz Gonzalez, R. Bonyadi, P. Alexakis, L. Ran and P. Mawby “Robustness and Balancing of Parallel-Connected Power Devices: SiC Versus CoolMOS,” IEEE Trans. On Ind. Elec. Vol. 63, no.4, pp.2092-2102 April 2016.
[13] M. Nawaz “Evaluation of SiC MOSFET power modules under unclamped inductive switching test environment”, Journal of Microelec. Reliability, vol. 63, pp. 97-103, 2016.
[14] H. Chen, D. Divan “High Speed Switching Issues of High Power Rated Silicon-Carbide Devices and the Mitigation Methods” 2015 ECCE, pp.2254-2260.
[15] M. Pulvirenti, L. Salvo, G. Scelba, A.G. Sciacca, M. Nania, G. Scarcella, M. Cacciato, “Characterization and Modeling of SiC MOSFETs Turn On in a Half Bridge Converter”2019 IEEE En. Conv. Cong. and Expo. (ECCE2019).
[16] M. Pulvirenti, G. Monotoro, M. Nania, R. Scollo, G. Scelba, M. Cacciato, G. Scarcella, L. Salvo “Analysis of Transient Gate-Source OverVoltages in Silicon Carbide MOSFET Power Devices” 2018 IEEE En. Conv. Cong. and Expo. (ECCE2018).
[17] J. Mari, F. Carastro, M.-J. Kell, P. Losee, T. Zoels “Diode snappiness from a user’s perspective” 2015, 17th European Conference on Power Electronics and Applications (EPE''''''''15 ECCE-Europe).
[18] R. Wu, F. Blaabjerg, H. Wang, M. Liserre, “Overview of catastrophic failures of freewheeling diodes in power electronic circuits”, Microelectronics Reliability, vol. 53, no.9-11, 2013, pp.:1788-1792.
[19] Y. Shi, R. Xie, L. Wang, Y. Shi, and H. Li, “Switching Characterization and Short-Circuit Protection of 1200V SiC MOSFET T-Type Module in PV Inverter Application”, IEEE Trans. on Ind. Electron., to be published.
[20] R. Katebi, J.He, N. Weise “An Advanced Three-Level Active Neutral-Point-Clamped Converter With Improved Fault-Tolerant Capabilities,” IEEE Trans. On Power Elect., vol. 33, no.8, pp. 6897-6909, Aug. 2018.
推薦閱讀:



