【導讀】從20nm技術節(jié)點開始,漏電流一直都是動態(tài)隨機存取存儲器(DRAM)設計中引起器件故障的主要原因。即使底層器件未出現(xiàn)明顯的結構異常,DRAM設計中漏電流造成的問題也會導致可靠性下降。漏電流已成為DRAM器件設計中至關重要的一個考慮因素。
從20nm技術節(jié)點開始,漏電流一直都是動態(tài)隨機存取存儲器(DRAM)設計中引起器件故障的主要原因。即使底層器件未出現(xiàn)明顯的結構異常,DRAM設計中漏電流造成的問題也會導致可靠性下降。漏電流已成為DRAM器件設計中至關重要的一個考慮因素。
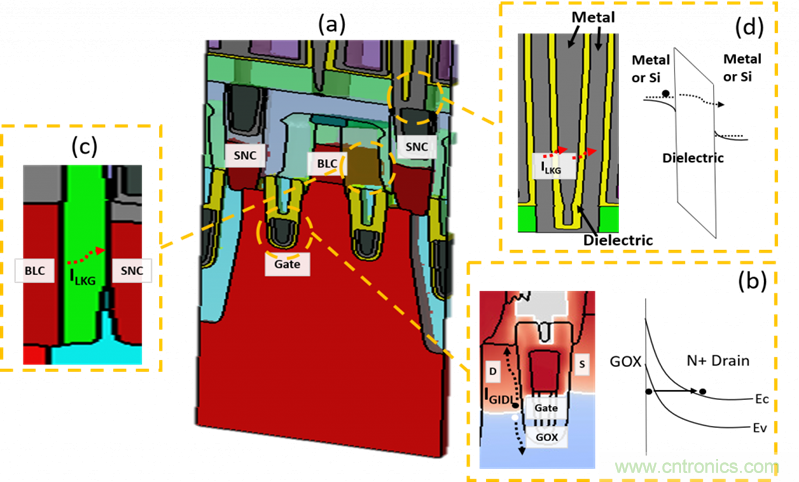
圖1. (a) DRAM存儲單元;(b)單元晶體管中的柵誘導漏極泄漏電流 (GIDL);(c)位線接觸 (BLC) 與存儲節(jié)點接觸 (SNC) 之間的電介質(zhì)泄漏;(d) DRAM電容處的電介質(zhì)泄漏。
DRAM存儲單元(圖1 (a))在電源關閉時會丟失已存儲的數(shù)據(jù),因此必須不斷刷新。存儲單元在數(shù)據(jù)丟失前可存儲數(shù)據(jù)的時間, 即保留時間,是DRAM的一個關鍵特性,保留時間的長短會受到漏電流的限制。
有兩種重要的漏電機制會影響DRAM的數(shù)據(jù)保留時間。第一種是單元晶體管漏電。DRAM中的單元晶體管漏電主要由于柵誘導漏極泄漏電流(GIDL)(圖1 (b)),它是由漏結處高電場效應引起的漏電流。在負柵偏置下,柵極會產(chǎn)生一個耗盡區(qū)(N+漏極區(qū)),該耗盡區(qū)進而在區(qū)域中產(chǎn)生一個增強電場,這個電場造成的能帶彎曲則導致了帶間隧穿(BTBT)。此時,在柵極移動的電子和少數(shù)載流子可以穿過隧道進入漏極,從而產(chǎn)生不必要的漏電流。
DRAM中的第二種漏電機制是位線接觸 (BLC) 與存儲節(jié)點接觸 (SNC) 之間的電介質(zhì)泄漏(圖1 (c))。電介質(zhì)泄漏通常發(fā)生在電容內(nèi)部,此時電子流過金屬和介電區(qū)域(圖1 (d))。當電子通過電介質(zhì)層從一個電極隧穿到另一個電極時,便會引起電介質(zhì)泄漏。隨著工藝節(jié)點的縮小,BLC和SNC之間的距離也在逐漸縮短,因此,這個問題正在變得愈發(fā)嚴重。這些結構元件的制造工藝偏差也會對位線接觸和存儲節(jié)點接觸之間的電介質(zhì)泄漏產(chǎn)生負面影響。
虛擬制造平臺SEMulator3D®可使用設計和工藝流數(shù)據(jù)來構建DRAM器件的3D模型。完成器件的“虛擬”制造之后,用戶可通過SEMulator3D查看器從任意方向觀察漏電路徑,并且可以計算推導出總的漏電值。這一功能對了解工藝變化對DRAM漏電流的影響大有幫助。SEMulator3D中的漂移/擴散求解器能提供電流-電壓 (IV) 分析,包括GIDL和結點漏電計算,以實現(xiàn)一體化設計技術的協(xié)同優(yōu)化。用戶還可以通過改變設計結構、摻雜濃度和偏置強度,來查看漏電值的變化。
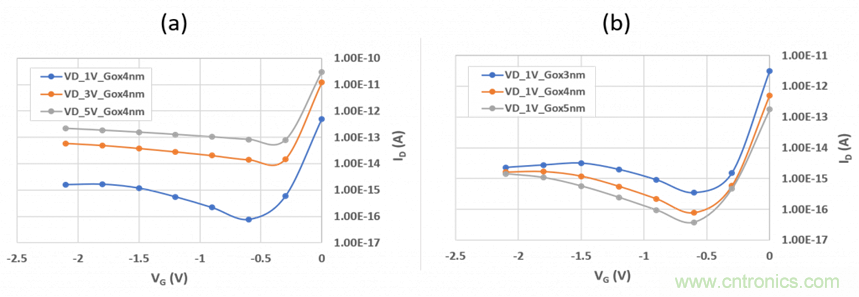
圖2. (a)在不同漏極電壓下,柵極電壓和漏極電流的變化曲線;(b)在不同柵極氧化層厚度 (+/-1nm) 下,柵極電壓和漏極電流的變化曲線。
圖2表明GIDL會隨著柵極氧化層厚度的變化而增加。柵極氧化層越薄,建模器件的柵極與漏極之間的電勢越高。
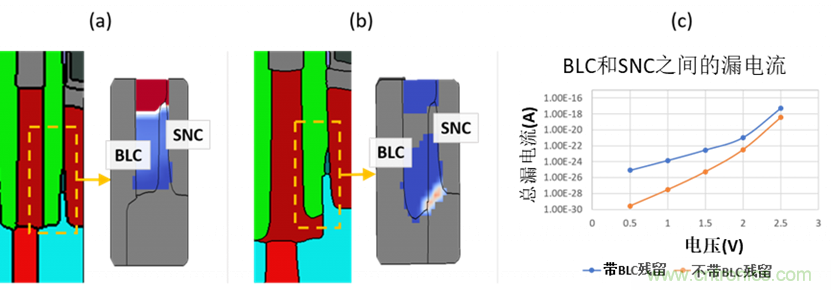
圖3. (a)和(b)帶BLC殘留和不帶BLC殘留結構中BLC和SNC之間的漏電流;(c)電壓掃描下總漏電流的變化。
圖3顯示了SEMulator3D中的電介質(zhì)泄漏路徑以及位線接觸和存儲節(jié)點接觸之間的總電流差,突出了刻蝕工藝過程中BLC的制造偏差帶來的影響。如圖3 (c)所示,由于工藝偏差的影響,帶BLC殘留結構的總漏電流高于不帶BLC殘留結構的總漏電流。
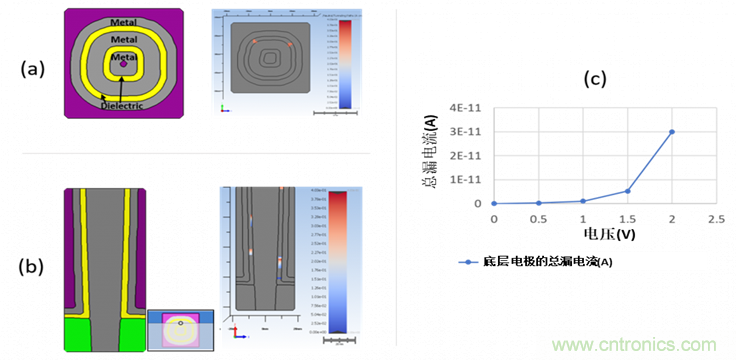
圖4. (a) DRAM電容Z平面截面圖像及電介質(zhì)泄漏路徑;(b)電容X平面界面圖像及電介質(zhì)泄漏路徑;(c)總漏電流與偏置強度的變化曲線。
圖4所示為DRAM電容的電介質(zhì)泄漏的例子。圖4 (a)和4 (b)分別是DRAM的Z平面和X平面截面圖,以及在SEMulator3D器件模型中觀察到的電介質(zhì)泄漏路徑在這兩個平面上的投影。圖4 (c)顯示了位于底層 (BTM) 電極的漏電流隨著外加的偏置而變化。
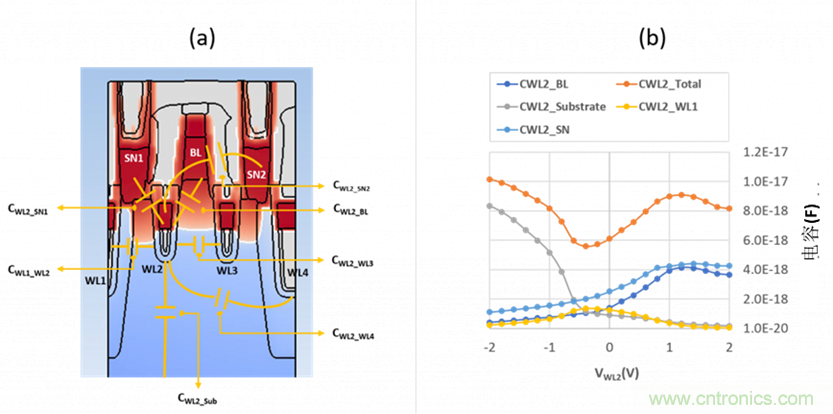
圖5. (a) DRAM單元的摻雜濃度視圖,顯示了將交流信號施加到字線WL2時,字線WL2和其他節(jié)點處的電容類型(和預期位置);(b)字線WL2和器件上其他節(jié)點之間的電容計算值。
影響DRAM性能的另一個重要因素是器件的寄生電容。DRAM開發(fā)期間應進行交流(AC)分析,因為位線耦合會導致寫恢復時間(tWR)延遲,并產(chǎn)生其他性能故障。由于摻雜的多晶硅不僅用于晶體管柵極,還用于位線接觸和存儲節(jié)點接觸,這會導致多個潛在的寄生電容產(chǎn)生(見圖5 (a)),所以必須對整個器件進行電容測量。SEMulator3D內(nèi)置AC分析功能,可測量復雜的模擬3D結構的寄生電容值。例如,通過模擬將交流小信號施加到字線WL2,SEMulator3D可以獲取全新設計的DRAM結構中字線WL2與其它所有節(jié)點之間的電容值,以及它們隨著電壓變化而變化的曲線(圖5 (b))。
總而言之,多種來源的漏電流和寄生電容會引起DRAM的故障。在DRAM開發(fā)期間,工程師需仔細評估這些故障模式,當然也應該考慮工藝變化對漏電流和寄生電容的影響。通過使用預期工藝流程和工藝變化來“虛擬”構建3D器件,然后分析不同工藝條件下的寄生和晶體管效應,可以簡化DRAM的下一代尋徑過程。SEMulator3D集成了3D工藝模型、R/C分析和器件分析功能,可以快速地驗證DRAM器件結構在不同工藝假設下是否容易發(fā)生漏電流或寄生電容故障。
Reference
1. M. T. Bohr, “Nanotechnology Goals and Challenges for Electronic Applications,” IEEE Trans. on Nanotechnology, 1, 1, 56-62 (2002)
2. J. H. Chen, S. C. Wong, Y. H. Wang, “An analytical three terminal Band-to-Band tunneling model on GIDL in MOSFET,” IEEE Trans. on Electron devices, 48, 1400-1405 (2001)
(來源:電子創(chuàng)新網(wǎng),作者:Tae Yeon Oh, 泛林集團半導體工藝及整合高級工程師)
免責聲明:本文為轉(zhuǎn)載文章,轉(zhuǎn)載此文目的在于傳遞更多信息,版權歸原作者所有。本文所用視頻、圖片、文字如涉及作品版權問題,請聯(lián)系小編進行處理。




