【導(dǎo)讀】目前瑞士和中國的研究人員共同制造出具有五個(gè)III族氮化物半導(dǎo)體溝道能級的三柵極金屬氧化物半導(dǎo)體高電子遷移率晶體管,從而提高了靜電控制和驅(qū)動(dòng)電流。
目前瑞士和中國的研究人員共同制造出具有五個(gè)III族氮化物半導(dǎo)體溝道能級的三柵極金屬氧化物半導(dǎo)體高電子遷移率晶體管,從而提高了靜電控制和驅(qū)動(dòng)電流。
瑞士洛桑聯(lián)邦理工學(xué)院(EPFL)和中國的Enkris半導(dǎo)體公司所制造的材料結(jié)構(gòu)由5個(gè)平行層組成,包括10nm氮化鋁鎵(AlGaN)阻擋層,1nm AlN間隔層和10nm GaN溝道(圖1)。其中阻擋層是以5x1018/cm3的部分水平摻雜硅以增強(qiáng)導(dǎo)電性。
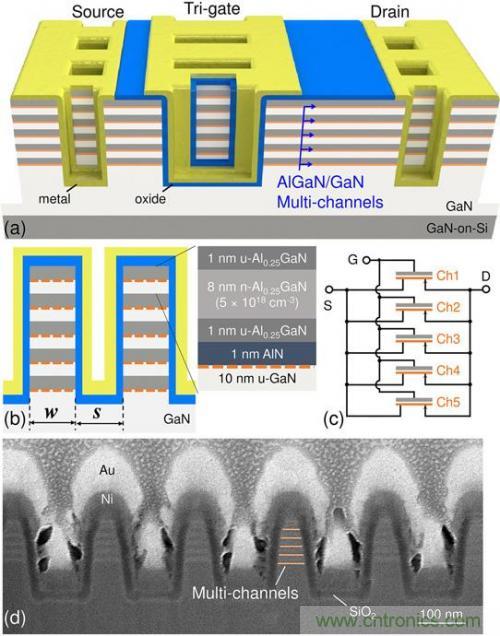
圖1:(a)多溝道三柵AlGaN / GaN MOSHEMT的示意圖。(b)三柵區(qū)的橫截面示意圖。插圖:多通道異質(zhì)結(jié)構(gòu)。(c)等效電路。(d)三柵區(qū)域的橫截面掃描電子顯微鏡圖像,傾斜52°。
在五個(gè)平行的薄二維電子氣(2DEG)通道上的霍爾測量給出了薄層電阻為230Ω/平方,具有1.5x1013/cm2的載流子密度和1820cm2/V-s遷移率(μ)。有效電阻率(ρeff)為2.4mΩ-cm,但總厚度(ttot)較小。該團(tuán)隊(duì)稱:“小的ρeff和高遷移率對于降低RON至關(guān)重要,總厚度較薄,有助于靜電柵極控制和器件制造(高縱橫比鰭片的刻蝕以及在它們周圍形成電極可能會(huì)具有挑戰(zhàn)性。)”
通過電感耦合刻蝕實(shí)現(xiàn)了三柵極結(jié)構(gòu),深度為200nm。歐姆源極/漏極觸點(diǎn)由退火的鈦/鋁/鈦/鎳/金組成。柵極堆疊是25nm原子層沉積(ALD)二氧化硅絕緣體和鎳/金電極。
一個(gè)器件的柵極長度為51μm:50μm的鰭片長度+2x0.5μm的源極和漏極延伸。而通道電流的控制受到鰭片寬度的影響。特別是,對于寬鰭片來說,它對較深通道的控制是緩慢的。當(dāng)寬度大于200nm時(shí),跨導(dǎo)顯示出五個(gè)峰(每個(gè)通道一個(gè)峰 )。峰值以40nm寬度合并。40nm器件顯示出-0.08V的小負(fù)閾值,改善了101mV /十倍的亞閾值擺幅和29.5mS / mm的峰值跨導(dǎo)。
當(dāng)然,減小鰭片寬度往往會(huì)降低導(dǎo)通狀態(tài)下的漏極電流。多個(gè)通道在一定程度上彌補(bǔ)了這一點(diǎn)。隨著單通道器件中鰭片寬度的減小,最大電流穩(wěn)定下降,而對于五個(gè)通道,只有寬度小于200nm時(shí)才會(huì)出現(xiàn)明顯的影響。對于100nm寬的鰭片,單通道電流相對于平面柵極減少了41%; 5通道減少僅為12%。
研究人員解釋道,“多通道結(jié)構(gòu)極大地減輕了三柵極(MOS)HEMT中的電子 - 電子和側(cè)壁散射。”單通道器件中的電子緊密堆積,增加了電子 - 電子碰撞的速率,從而增加了電阻;而進(jìn)一步阻力來自更多電子撞擊鰭片側(cè)壁。多通道結(jié)構(gòu)則減少了單獨(dú)通道中的電子擁擠。
高壓MOSHEMT,其柵極漏極間距為10μm,鰭片為700nm長,100nm寬,鰭片之間的間距為100nm,填充因子為50%。柵極金屬向源極延伸0.5μm,在漏極方向延伸1.3μm,總長度為2.5μm。
制造兩個(gè)具有相似尺寸的單通道參考器件:一個(gè)具有平面,另一個(gè)具有三柵極結(jié)構(gòu)。這些參考器件中的阻擋層是GaN溝道上典型的20nm Al0.25Ga0.75N 。
多通道三柵極器件的導(dǎo)通電阻降低(圖2),與單通道三柵極基準(zhǔn)相比,導(dǎo)通電阻幾乎為一半,最大漏極電流增加了三倍以上。通過器件寬度歸一化,多通道MOSHEMT的導(dǎo)通電阻為6.0Ω-mm,而單通道器件的導(dǎo)通電阻為11.2Ω-mm。多通道和單通道最大漏極電流分別為797mA / mm和252mA / mm。

圖2:(a)5V柵極電位(VG)時(shí)的輸出特性和(b)5V漏極偏置(VD)下的傳輸特性,通過器件占位寬度進(jìn)行歸一化。(c)多通道三柵極晶體管的傳輸特性,在5V VD時(shí)具有20nm的鰭寬度和10%的填充因子。插圖:兩個(gè)鰭片長度(l)的閾值電壓(VTH,1μA/ mm電流)與鰭片寬度(w)。(d)用浮動(dòng)基板測量的多通道三柵極晶體管的典型斷態(tài)擊穿特性。
該團(tuán)隊(duì)稱:“這些結(jié)果表明多通道三柵極技術(shù)可以降低晶體管在給定器件占位面積上的傳導(dǎo)損耗,或者等效地在更小的器件占位面積內(nèi)提供給定的電流額定值, 這對高效功率晶體管非常有益。“
與平面參考相比,多通道MOSHEMT的導(dǎo)通電阻降低了38%,最大漏電流增加了41%。與平面設(shè)置的100%相比,鰭片結(jié)構(gòu)的填充系數(shù)為50%。
通過從平面基準(zhǔn)移動(dòng)到多通道鰭片MOSHEMT,閾值電壓變得更正(從-7.6V變?yōu)椋?.6V)。多通道器件的峰值跨導(dǎo)也增加了2.4倍(從66.1mS / mm到156.6mS / mm)。多通道MOSHEMT的開/關(guān)電流比約為1010。
研究人員利用20nm的鰭片寬度(700nm長度)實(shí)現(xiàn)了0.82V的正閾值電壓,1μA/ mm。
簡析功率MOSFET的熱阻特性
ASM生產(chǎn)網(wǎng)絡(luò)被授予“年度最佳工廠”
分析反饋電路的工作原理及作用
高速運(yùn)算放大器的3個(gè)PCB電路設(shè)計(jì)技巧
PCB設(shè)計(jì)如何影響電源EMC性能?






